PECVD去除二氧化硅与RIE的区别是什么?
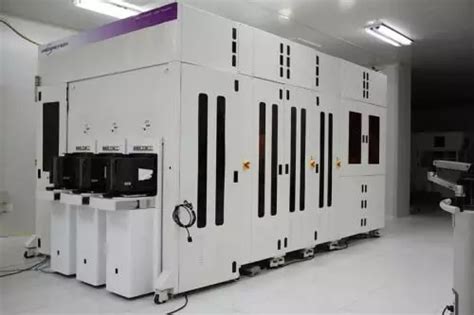
RIE:Reactive Ion Etching, 作为蚀刻用途,那么需要一个向下轰击的能量,所以蚀刻用的设备下电极都必须有一个RF power 。PECVD:是用于沉积膜,只需要将气体离子化,增加薄膜沉积速率,而应该避免向下轰击的作用,所以PEVCD的RF power都是加在上电极 。2、Plasma内化学性腐蚀是没有方向性的,但是离子的轰击有方向性,就是靠Plamsa的正负离子的移动产生DC Bias, 该DC bias的大小除了与RF,腔体结构有关外,还与电极的大小有关 。
电极小的一端产生的DC Bias较大 。RIE腔体,RF不管是加在上电极还是下电极,只要下电极维持高的DC bias就行 。PECVD 下电极(wafer)接地,不产生DC Bias 。Sputter的较大DC bias加在靶材一极 。3、RF的电极接法不同时,所产生的效果完全不同:通常也有电极接在下电极的PECVD,不过此法之电极会常常导致轰击的效应,成膜的质量通常会较差甚至是peeling,尤其是组件的电性常会受到损伤的 。
更差的状况是堆积的膜的速率小于自我轰击的速率,因此而无法成膜上去的 。因此一般PECVD不会将电极接在下电极 。ICP 与 PECVD 的区别1. ICP有上下两个电极(射频RF),PECVD是不是也有上下两个电极(射频RF)?答:PECVD也有上下两个电极,不同的工艺配置不同,有些工艺如PE SiO2就只用到上电极(HF) 。
ICP是上电极加低频(LF)感应耦合产生等离子体,下电极加高频(HF)来产生偏置电压提供离子能量;而PECVD则相反,上电极加高频(HF)用来离化反应气体,下电极加低频(LF)提供偏置电压控制膜应力 。ICP:属电感耦合机构,除了上下电极还有一个偏压电极.加强离子蚀刻PECVD:属于电容耦合机构,仅上下电极.一般属阳极耦合而RIE属阴极耦合2.ICP有ESC,并且要求HE冷却,同时片台的温度要保持在20度 。
PECVD呢?答:PECVD因为是等离子体化学气相淀积,一定的工艺温度必不可少,一般温度控制在350-400度左右 。ICP:怕芯片过热造成蚀刻不均;PECVD:怕腔体外部太热3.ICP有DC BIAS 和VPP的指标,PECVD是否有?答:由于ICP与PECVD的工艺原理有差别,所有PECVD一般没有DC BIAS和VPP的指标,只需控制FORWARD POWER就OK了 。
【PECVD,NAURA创新】ICP:属电感耦合机构.除了上下电极还有一个偏压电极.所以有BIAS 和VPP的指标 。PECVD:属于电容耦合机构.仅上下电极.一般属阳极耦合则没有你所谓的BIAS 和VPP的指标,而阴极耦合则有你所谓的BIAS 和VPP的指标4.ICP的上电极的DIW冷却到底冷却的什么地方?不会是冷却电极的线圈吧?还是冷却的什么其它地方?PECVD呢?答:ICP上电极的DIW用来冷却感应线圈的,而PECVD的电极部分一般无需冷却 。
推荐阅读
- 创新live,双11想入个耳机k450和创新live哪个好
- 做什么生意创新,乡镇做什么生意好
- 创新宣传方式
- 可视化网络安全技术创新者,安博通
- 太原师范学院教务网络管理系统,互联网 背景下的高校管理创新
- 五大主流SQL数据库,主流数据库
- 创新声卡5.1多少钱 创新声卡5 1
- 业务模式再创新,世纪佳缘联营店是什么意思
- 创新,就是解决实际难题
- 小学生科技创新大赛优秀作品,科技创新大赛作品
















