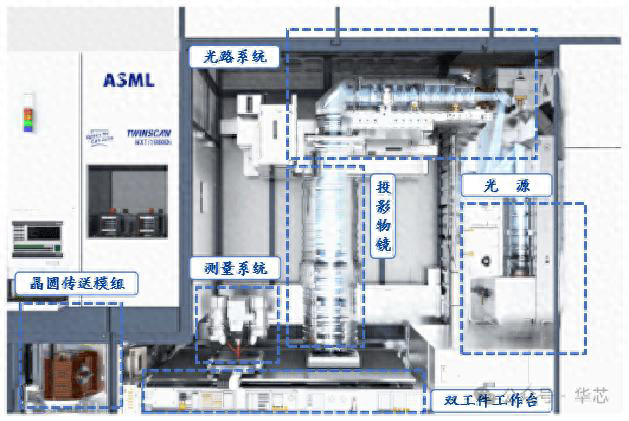
文章图片
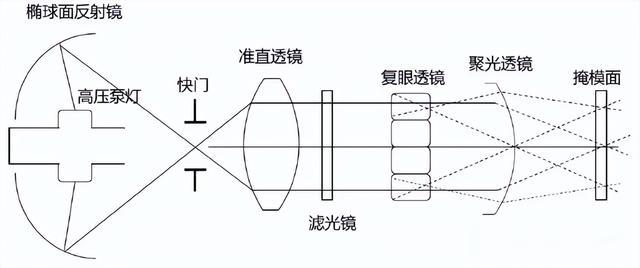
文章图片

文章图片

文章图片
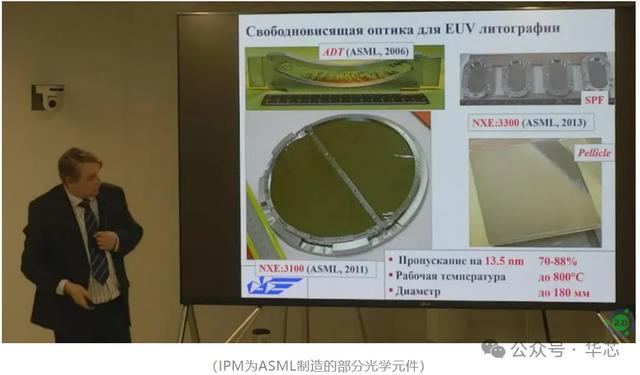
文章图片
光刻机架构
光刻机主要由光源、光路系统及物镜、双工件台、测量系统、聚焦系统、对准系统等部分组成 。 其中 , 晶圆模组部分主要负责曝光前晶片的测量与参数录入 , 照明光学模组部分完成晶圆的曝光 。 在晶圆模组部分:晶圆传送模组中 , 由机械手臂负责将晶圆由光阻涂布机传送到晶圆平台模组 。 而晶圆双平台模组负责在一片晶圆曝光的同时 , 将待曝光晶圆进行预对准 , 随后对其表面高低起伏的程度进行测量 , 并将相关坐标录入计算机 。 由此 , 在不到0.15秒的单位曝光时间内 , 硅片承载台可以精准快速移动以达到最好的曝光效果 。
在照明光学模组部分:紫外光从光源模组生成后 , 被导入到照明模组 , 并经过矫正、能量控制器、光束成型装置等后进入光掩膜台 , 随后经过物镜补偿光学误差 , 最后将线路图曝光在已测量对准的晶圆上 。
光源系统
光源系统的核心作用:光源波长直接影响光刻工艺的精度 , 波长越短 , 能够制造的晶体管线宽越小 , 从而提高芯片的性能 。
光刻技术随着光源波长的缩短而不断进步 , 从早期的高压汞灯照明到后来的深紫外光(DUV)和极紫外光(EUV) 。
高压汞灯
高压汞灯照明主要对g ( 4 3 6 n m ) 、h(405nm)、i(365nm)三线进行曝光 。 其采用汞蒸气发电放光 。 工作原理:放电管内有启动用的氩气和放电用的汞 , 通过在电极之间施加高压脉冲 , 使气体电离 ,电弧的热量使汞蒸气激发 , 汞原子从基态跃迁到激发态 。 激发态的汞原子不稳定 , 会迅速返回到基态 , 在这个过程中释放出能量 , 以光的形式发出 。 汞原子的这种跃迁主要产生紫外线 , 特别是波长为436nm、405nm和365nm的谱线 , 这些波长对于早期光刻技术非常重要 。
(高压汞灯光刻光源)
第三代和第四代光刻机光源为深紫外光(DUV) , 使用准分子激光器产生 , 可实现KrF、ArF和F2 。 随着制程节点的缩小 , 短波长的极紫外光(EUV)无法从激光器中产生 , 需通过高能脉冲激光轰击液态锡靶形成等离子体后产生 。 其原理是激光放电箱体内充有由卤素气体(如氟F)和缓冲气体(氩Ar , 氪Kr)构成的混合气体作为工作介质 , 气体受到来自高压脉冲的放电激励产生等离子态时 ,能级跃迁导致处于激励能级的原子或分子与激发态的原子或分子相互作用 , 形成准分子激发态 。 这些激发态分子的寿命非常短暂 , 仅几纳秒 , 它们会发生电荷转移或电化学反应 ,产生高能量的光子 , 从而辐射出深紫外光 。
极紫外光光源
极紫外光由高能激光轰击金属锡产生等离子体辐射产生 , 其过程首先使用特殊的液滴发生器产生微小的锡液滴 , 这些液滴在真空室内被连续喷射出来 。 接下来 , 使用高功率的CO2激光器发出两个激光脉冲 , 第一个是预脉冲 , 它将锡液滴压扁成直径约500微米的扁平圆盘形状 , 而第二个主脉冲则用于将扁平的锡液滴电离 , 产生等离子体 。
(极紫外光源双脉冲)
电离过程中 , 锡原子被激发到高能态 , 并在跃迁回低能态时发出极紫外光 。 产生的极紫外光随后被收集镜收集 , 并经过光谱纯化 , 以确保光的波长和方向符合光刻要求 。 经过纯化的极紫外光被传输至光刻系统 , 在那里 , 光束将通过掩模和投影系统 , 最终曝光在硅晶圆上 , 形成所需的电路图案 。
(等离子体转换成13.5nm光的过程)
光源系统技术难点:
足够大的光源功率 , 长时间的高可靠性工作 , 精密程度高光路系统 。
光刻机的光路系统包括照明系统和投影物镜
光刻机照明系统
照明系统位于光源和掩膜版之间 , 它为投影物镜成像提供特定光线角谱和强度分布的照明光 。 照明系统包括光束处理 ,光瞳整形 , 能量探测 , 光场均化 , 中继成像 , 和偏振照明等单元 。
光源经过扩束器得到更大的光束尺寸 , 以便后续的整形和匀化处理 , 通过整直确保光束的形状 , 尺寸 , 和发散角符合光刻过程的要求 。 匀光单位能确保光束在掩膜面上形成均匀的照明分布 。 扫描狭缝用来确定包括视场尺寸和中心位置 , 控制曝光区域和曝光剂量 。 中继镜组位于扫描狭缝和掩膜版之间 , 负责将经过前面各级处理后的照明光场传输到掩膜面上 。
投影物镜
投影物镜的作用是将掩膜版上的图案通过光学系统缩小 , 并精确投射到硅片表面上 。 物镜的设计和生产非常复杂 , 需要考虑各种光学性能 , 如球差 , 色差 , 散焦 , 场曲 , 等像差问题 。 物镜的性能直接决定了光刻机的线宽 , 套刻精度 。 对环境控制(温度 , 气压)、冷镜头/热镜头的像差补偿、镜头表面平整度等等都有极致要求 。 蔡司生产的最新一代EUV光刻机反射镜最大直径1.2米 , 表面粗糙度0.02纳米 , 达到了原子级别的平坦 。
投影物镜主要分为全折射型和折反型 , 对于NA>1.2的投影物镜 , 大多采用折反式【NA/数值孔径 , NA越大 , 光学系统分辨率越高】 。
蔡司是目前唯一掌握EUV光学器件的企业 , 于1968年开始涉足半导体领域 , 2010年公司研发全球第一套EUV光学系统 。
【参考观察者网文章《 俄罗斯 , 会比中国先造出EUV光刻机?》显示 , 俄罗斯科学院微结构物理研究所在ASML早期EUV研究中 , 也为其提供过光学器件 。】
(图片来源:观察者网《 俄罗斯 , 会比中国先造出EUV光刻机?》青岚)
双工件台系统
光刻机的双工件台是一种先进的技术 , 它允许一台光刻机内部同时有两个承载晶圆的工件台独立运行 , 从而显著提高光刻机的产能和效率 。 在双工件台系统中 , 一个工件台上的晶圆进行曝光操作时 , 另一个工件台可以进行测量和其他曝光前的准备工作 。 当曝光完成之后 , 两个工件台会交换位置和职能 , 实现高效的循环作业 。
双工件台的技术难点包括对准精度要求高 , 运动速度快 , 运作稳定 。
(清华大学双工件台)
【半导体设备(04) 光刻机】免责申明:全文转自微信公众号 半导农夫 华芯 。 感谢原文作者的贡献 , 仅用于学习和普及 。 如有侵权 , 请联系删除 。
推荐阅读
- 芯片产业有望开启新一轮繁荣周期,国产半导体设备如何乘风而起?
- 中国光刻机取得突破开始量产,美西方急了,指责不该研发光刻机
- 跳过浸润式DUV,我们的目标,是直接研发EUV光刻机
- 佳能NIL设备出货:不需要EUV,制造5nm芯片,成本低90%
- 60台光刻机,1000亿元!荷兰正式宣布,外媒:ASML开始秋后算账了
- 美方没有料到,“中国芯”多次反转,外媒: 半导体限制已经失效了
- 光刻机维修遇阻?ASML紧急宣布,外媒:中国造芯之路要被封堵了
- 外媒: 光刻机限制尘埃落定了
- 韩企无视美国禁令,勇破美芯片封锁,8台EUV光刻机坚定支持中国!
- 耍流氓?中国首台光刻机实现量产!美国、荷兰紧急发声:强烈谴责












